Flip Chip Ball Grid Array (FCBGA or simply Flip-chip BGA) is a mid-cost, high-performance, semiconductor packaging solution that utilizes the controlled collapse chip connection technology, also known as flip chip, for its die to substrate interconnection. FCBGA provides the design flexibility for much higher signal density and functionality into a smaller die and packaging footprint. FCBGA packaging is attractive where performance is more important than cost. Flip-chip BGA packages can be mounted using standard printed circuit boards and can be replaced using existing standard repair practices.
Today most flip-chip BGA packages are assembled on two-metal layer or multi-layered, high density ceramic substrates or organic laminate. Additionally FCBGA packages are often offered in bare die, flat lid, and full lid configuration. They are used extensively ASIC, DSP, and various other high performance applications.
FCBGA packages is used in all main semiconductor manufacturers such as in the latest Intel's Core i7, Texas Instruments custom ASICs, and Freescale processors.
Contents
μFCBGA[edit]
μFCBGA or micro-FCBGA is a line of fcBGA packages that ships with Intel's line of processors.
- FCBGA 437 • FCBGA 559 • FCBGA 676 • FCBGA 1023
- FCBGA 1088 • FCBGA 1168 • FCBGA 1170
- FCBGA 1224 • FCBGA 1283 • FCBGA 1284
- FCBGA 1357 • FCBGA 1364 • FCBGA 1466
BGA/FCBGA[edit]
- FCBGA-437 • μFCBGA
| Package | FCBGA-437 (FCBGA) |
|---|---|
| Dimension | 22 mm x 22 mm x 1.6 mm |
| Pin Count | 437 |
| Socket | BGA-437 (BGA) |
| Package | FCBGA-441 (FCBGA) |
|---|---|
| Dimension | 13 mm x 14 mm |
| Pin Count | 441 |
| Socket | BGA-441 (BGA) |
| Package | FCBGA-518 (FCBGA) |
|---|---|
| Dimension | 13.8 mm x 13.8 mm x 1.1 mm |
| Pin Count | 518 |
| Socket | BGA-518 (BGA) |
| Package | FCBGA-1023 (BGA) |
|---|---|
| Dimension | 31 mm x 24 mm |
| Pitch | 0.65 mm |
| Contacts | 1023 |
| Package | FCBGA-1090 (BGA) |
|---|---|
| Dimension | 25 mm x 24 mm |
| Contacts | 1090 |
- FCBGA-1224 • μFCBGA
| Package | FCBGA-1224 (BGa) |
|---|---|
| Dimension | 31 mm x 24 mm |
| Pitch | 0.65 mm |
| Contacts | 1224 |
- BGA-1288 •
| Package | BGA-1288 (BGA) |  |
|---|---|---|
| Dimension | 34 mm x 28 mm x 2.1 mm | |
| Pitch | 0.7 mm | |
| Pin Count | 1288 |
| Package | FCBGA-1310 (BGA) |
|---|---|
| Dimension | 34 mm x 28 mm |
| Ball Count | 1310 |
| Ball Comp | SAC405 |
| Interconnect | BGA-1310 |
| Package | FCBGA-1356 (BGA) |
|---|---|
| Dimension | 42 mm x 24 mm x 1.3 mm |
| Pitch | 0.65 mm |
| Ball Count | 1356 |
| Ball Comp | SAC405 |
| Interconnect | BGA-1356 |
- FCBGA-1364 • μFCBGA
| Package | FCBGA-1364 (BGA) |
|---|---|
| Dimension | 37.4 mm x 32 mm |
| Pitch | 0.7 mm |
| Ball Count | 1364 |
| Ball Comp | SAC405 |
| Interconnect | BGA-1364 |
| Package | FCBGA-1440 (BGA) |
|---|---|
| Dimension | 42 mm x 28 mm x 1.49 mm |
| Pitch | 0.65 mm |
| Ball Count | 1440 |
| Ball Comp | SAC405 |
| Interconnect | BGA-1440 |
| Package | FCBGA-1528 (BGA) |
|---|---|
| Dimension | 46 mm x 24 mm x 1.3 mm |
| Ball Count | 1528 |
| Ball Comp | SAC405 |
| Interconnect | BGA-1528 |
| Package | FCBGA-2518 (BGA) |
|---|---|
| Dimension | 45 mm x 52.5 mm |
| Contacts | 2518 |
LGA/FCLGA[edit]
- LGA-1151 • FCLGA-1151, FC-LGA14C
| Package | FCLGA-1151 (LGA) FC-LGA14C |  |
|---|---|---|
| Dimension | 37.5 mm x 37.5 mm x 4.4 mm | |
| Pitch | 0.914 mm | |
| Contacts | 1151 | |
| Socket | LGA-1151 |
- LGA-1155 • FCLGA-1155 (LGA)
| Package | FCLGA-1155 (LGA) | 125px |
|---|---|---|
| Dimension | 37.5 mm x 37.5 mm | |
| Contacts | 1155 | |
| Socket | LGA-1155 |
- LGA-1567 • FCLGA-8 (LGA)
| Package | FCLGA-8 (LGA) | 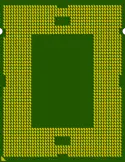 |
|---|---|---|
| Dimension | 49.1 mm x 56.4 mm x 4.2 mm | |
| Pitch | 1 mm | |
| Pin Count | 1567 | |
| Socket | LGA-1567 |
PGA/FCPGA[edit]
• Socket G1 (rPGA 988A) • Mobile Core i (Gen 1), Pentium, Celeron • Socket G2 (rPGA 988B) • Mobile Core i (Gen 2/3), Pentium, Celeron • Socket G3 (rPGA 946) • Mobile Core i (Gen 4), Pentium, Celeron
- Socket-G1 (PGA) • rPGA-988A (rPGA)
| Package | rPGA-988A (rPGA) | 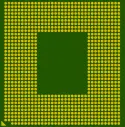 |
|---|---|---|
| Dimension | 36 mm x 35 mm x 2.12 mm | |
| Pitch | 1 mm | |
| Pin Count | 988 | |
| Socket | Socket-G1 (PGA) |
- Socket G2 (PGA) • PGA-988B (PGA)
| Package | rPGA988B (PGA) |
|---|---|
| Dimension | 37.5 mm x 37.5 mm |
| Pitch | 1 mm |
| Contacts | 988 |
| Socket | Socket G2 |
- FCPGA-946 (PGA) • rPGA-946B/947 (FCPGA-1364)
| Package | FCPGA-946 (PGA) |
|---|---|
| Dimension | 37.5 mm x 37.5 mm |
| Pitch | 1.0 mm |
| Pins | 946 |
| Interconnect | rPGA-946B/947 |
BGA CPU Packages[edit]
AMD BGA Packages[edit]
| BGA CPU Packages | |||||||
|---|---|---|---|---|---|---|---|
| General | Details | ||||||
| Name | Package | Contacts | TDP | Socket | µarch | Market | Release |
| Package ASB1 | ASB1, BGA-812 | 812 | 18 W 18,000 mW 0.0241 hp 0.018 kW | K8 | Mobile | 8 January 2009 | |
| Package ASB2 | ASB2, BGA-812 | 812 | 15 W 15,000 mW 0.0201 hp 0.015 kW | K10 | Mobile | 12 May 2010 | |
| Package CBGA-360 | CBGA-360 | 360 | 11 W 11,000 mW 0.0148 hp 0.011 kW | K6 | Mobile | 5 March 1998 | |
| Package FP2 | BGA-827, FP2 | 827 | 25 W 25,000 mW 0.0335 hp 0.025 kW | Piledriver | Mobile, Embedded | 15 May 2012 | |
| Package FP3 | BGA-854, FP3 | 854 | 35 W 35,000 mW 0.0469 hp 0.035 kW | Steamroller | Mobile, Embedded | June 2014 | |
| Package FP4 | BGA-968, FP4 | 968 | 45 W 45,000 mW 0.0603 hp 0.045 kW | Excavator | Mobile, Embedded | June 2015 | |
| Package FP5 | BGA-1140 | 1,140 | 45 W 45,000 mW 0.0603 hp 0.045 kW | Zen, Zen+ | Mobile, Embedded | 8 January 2018 | |
| Package FP6 | BGA-1140 | 1,140 | 55 W 55,000 mW 0.0738 hp 0.055 kW | Zen 2, Zen 3 | Mobile, Embedded | 16 March 2020 | |
| Package FT1 | BGA-413, UOB-413 | 413 | 18 W 18,000 mW 0.0241 hp 0.018 kW | Bobcat | Mobile, Embedded | 4 January 2011 | |
| Package FT3 | BGA-769 | 769 | 25 W 25,000 mW 0.0335 hp 0.025 kW | Jaguar | Mobile, Embedded | May 2013 | |
| Package FT3b | BGA-769 | 769 | 25 W 25,000 mW 0.0335 hp 0.025 kW | Puma | Mobile, Embedded | 4 June 2014 | |
| Package FT4 | BGA-769 | 769 | 15 W 15,000 mW 0.0201 hp 0.015 kW | Excavator | Mobile | June 2016 | |
| Package OBGA-349 | OBGA-349 | 349 | 18 W 18,000 mW 0.0241 hp 0.018 kW | K6 | Embedded | 25 September 2000 | |
| Package SP1 | BGA-1021 | 1,021 | 32 W 32,000 mW 0.0429 hp 0.032 kW | Cortex-A57 | Embedded, Server | January 2016 | |
| Package SP4 | BGA-2028 | 2,028 | 100 W 100,000 mW 0.134 hp 0.1 kW | Zen | Embedded | 21 February 2018 | |
| Package SP4r2 | BGA-2028 | 2,028 | 55 W 55,000 mW 0.0738 hp 0.055 kW | Zen | Embedded | 21 February 2018 | |
Intel BGA Packages[edit]
- FCBGA-1377 (26.5 x 18.5 mm) • Ice Lake Y
- FCBGA-1392 • Cannon Lake Y
- FCBGA-1440 (42 x 28 mm) • Coffee Lake H, HR
- FCBGA-1510 • Cannon Lake U
- FCBGA-1515 (20 x 16.5 mm) • Amber Lake Y
- FCBGA-1526 (50 x 25 mm) • Ice Lake U
- FCBGA-1528 • Whiskey Lake U
- FCBGA-1667 (37.5 x 37.5 mm) • Broadwell DE, Hewitt Lake
- FCBGA-2579 • Ice Lake D
- FCBGA-3325 (60 x 60 mm) • Intel Nervana
- FCBGA-5903 • Cascade Lake AP
Intel LGA Packages[edit]
- FCLGA-1151 • FCLGA14C (37.5 x 37.5 mm) • Coffee Lake S, E
- • LGA-1151 • Socket H4
- FCLGA-8 • Intel Xeon E7 (Westmere, Ivy Bridge, Haswell, Broadwell)
- • LGA-1567 • Socket LS
- FCLGA-1700 (45.0 x 37.5 mm) • Alder Lake S
- • LGA-1700 • Socket V
- FCLGA-2066 (52.5 x 45 mm) • Skylake X, Skylake X Refresh
- • LGA-2066 • Socket R4
- FCLGA-3647 (76.2 x 56.6 mm) • Skylake SP, Cascade Lake SP
- • LGA-3647 • Socket P
- FCLGA-4189 • Ice Lake SP
- • LGA-4189 • Socket P+ (W)
- FCLGA-2601 (50 x 50 mm) • IBM Power9 Sforza
- • PLGA-2601
Intel CPU Packages[edit]
- FCBGA-437 • BGA-437 • Bonnell
- FCBGA-441 • BGA-441 • Bonnell
- FCBGA-518 • BGA-518 • Bonnell
- rPGA-988A • Socket G1 • Westmere
- rPGA-988B (FCBGA-1023/FCBGA-1224) • Socket G2 • Sandy Bridge
- FCBGA-1023 • Sandy Bridge
- FCBGA-1090 • Goldmont Plus
- FCLGA-1151 • LGA-1151 • Skylake • Kaby Lake
- FCLGA-1151 (FCLGA14C) • Socket H4 • Coffee Lake
- FCBGA-1288 • BGA-1288 • Westmere
- FCBGA-1310 • Goldmont
- FCBGA-1356 • BGA-1356 • Skylake • Kaby Lake
- FCBGA-1440 • Coffee Lake
- FCBGA-1510 • Cannon Lake
- FCBGA-1528 • Coffee Lake • Whiskey Lake
- LGA-1567 • FCLGA-8 • Intel Xeon E7 (Westmere, Ivy Bridge, Haswell, Broadwell)
- FCLGA-2011-v3 • LGA-2011-v3 • Westmere, Ivy Bridge, Haswell, Broadwell
- FCLGA-2066 • Socket R • Skylake • Kaby Lake
- FCLGA-2066 • Socket R4 • Skylake (server) • Cascade Lake
- FCBGA-2518 • Skylake (server)
- FCBGA-2579 • Ice Lake (server)
- FCBGA-3325 • Spring Crest
- FCLGA-3647 • Socket P • Cascade Lake • Skylake (server)
- FCLGA-4189 • LGA-4189 • Socket P+ (W) • Ice Lake (server)
- FCBGA-5903 • Cascade Lake
| Intel CPU Packages | |||||||
|---|---|---|---|---|---|---|---|
| General | Details | ||||||
| Package | Name | Contacts | TDP | Socket | µarch | Market | Release |
| FCLGA-8 | Intel Xeon E7 | LGA-1567 | Westmere, Ivy Bridge, Haswell, Broadwell | 5 April 2011 | |||
| FCLGA-8 | Xeon E7-2803 | 105 W 105,000 mW 0.141 hp 0.105 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-2820 | 105 W 105,000 mW 0.141 hp 0.105 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-2830 | 105 W 105,000 mW 0.141 hp 0.105 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-2850 | 130 W 130,000 mW 0.174 hp 0.13 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-2860 | 130 W 130,000 mW 0.174 hp 0.13 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-2870 | 130 W 130,000 mW 0.174 hp 0.13 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-4807 | 95 W 95,000 mW 0.127 hp 0.095 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-4820 | 105 W 105,000 mW 0.141 hp 0.105 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-4830 | 105 W 105,000 mW 0.141 hp 0.105 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-4850 | 130 W 130,000 mW 0.174 hp 0.13 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-4860 | 130 W 130,000 mW 0.174 hp 0.13 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-4870 | 130 W 130,000 mW 0.174 hp 0.13 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-8830 | 105 W 105,000 mW 0.141 hp 0.105 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-8837 | 130 W 130,000 mW 0.174 hp 0.13 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-8850 | 130 W 130,000 mW 0.174 hp 0.13 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-8860 | 130 W 130,000 mW 0.174 hp 0.13 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-8867L | 105 W 105,000 mW 0.141 hp 0.105 kW | Westmere | Server | 5 April 2011 | ||
| FCLGA-8 | Xeon E7-8870 | 130 W 130,000 mW 0.174 hp 0.13 kW | Westmere | Server | 5 April 2011 | ||
See also[edit]
| Has subobject "Has subobject" is a predefined property representing a container construct and is provided by Semantic MediaWiki. | Flip Chip Ball Grid Array#package + |
| package | FCBGA-437 +, FCBGA-441 +, FCBGA-518 +, FCBGA-1023 +, FCBGA-1090 +, FCBGA-1224 +, BGA-1288 +, FCBGA-1310 +, FCBGA-1356 +, FCBGA-1364 +, FCBGA-1440 +, FCBGA-1528 +, FCBGA-2518 +, FCLGA-1151 +, FCLGA-1155 +, FCLGA-8 +, rPGA-988A +, rPGA988B + and FCPGA-1364 + |
| socket | BGA-437 +, BGA-441 +, BGA-518 +, LGA-1151 +, LGA-1155 + and Socket G2 + |